制御・計測・センシング
駆動・機械要素・電子制御部品
産業別カテゴリ
電源・エネルギー・熱処理機器
安全・保護・環境対策
材料・素材・ケミカル
電気・電子部品
構造部品・締結要素
ソフトウェア・ネットワーク
サービス
その他
全てのカテゴリ
閲覧履歴
ビルドアップ基板のメーカー36社一覧や企業ランキングを掲載中!ビルドアップ基板関連企業の2025年11月注目ランキングは1位:三和電子サーキット株式会社、2位:株式会社松和産業、3位:リンクステック株式会社です。
監修: OKIサーキットテクノロジー株式会社
ビルドアップ基板は、何層も積層されているプリント基板のことをいいます。
ビルドアップ基板を使用することで、小さい面積で、密度の高い基板が使用することができるので、小型の機器などでも多機能の製品を作成することができます。ビルドアップ基板は導体の層と絶縁体の層が何層も積み重なり、層を貫通するようにレーザーによる穴あけや配線加工がなされており、小さい面積の複雑な基板を入手することができます。
関連キーワード
2025年11月の注目ランキングベスト10
| 順位 | 会社名 | クリックシェア |
|---|---|---|
| 1 | 三和電子サーキット株式会社 |
14.3%
|
| 2 | 株式会社松和産業 |
9.5%
|
| 3 | リンクステック株式会社 |
7.1%
|
| 4 | 富士プリント工業株式会社 |
7.1%
|
| 5 | シイエムケイ・プロダクツ株式会社 |
4.8%
|
| 6 | サス・サンワ株式会社 |
4.8%
|
| 7 | 日本シイエムケイ株式会社 |
4.8%
|
| 8 | 株式会社キョウデン |
4.8%
|
| 9 | 株式会社大昌電子 |
4.8%
|
| 10 | 株式会社メイコー |
4.8%
|
業界別
💻 電子・電気機器項目別
使用用途
#車載
#通信機器
#センサー
#民生品
#UPS機器
#美容機器
#半導体テスター
#ゲーム機
#電子機器
#高速信号
層構成
片面ビルドアップ基板
多層ビルドアップ基板
ビア接続構造
スタックビア型
スタガビア型
層数 層
1 - 5
5 - 10
10 - 20
20 - 30
30 - 40
40 - 50
板厚 mm
0 - 1
1 - 2
2 - 3
3 - 4
最小線幅 μm
10 - 50
50 - 100
100 - 200
200 - 500
500 - 2,100
穴径 mm
0 - 0.2
0.2 - 0.3
0.3 - 0.4
ピッチ μm
80 - 100
100 - 150
150 - 200
200 - 350
表面処理
プリフラックス
鉛フリーはんだレベラ
金メッキ
無電解金メッキ
無電解錫メッキ
株式会社メイコー
680人以上が見ています
最新の閲覧: 20時間前
100.0% 返答率
53.2時間 返答時間
ビルドアップ基板は、絶縁層上に導体パターンを作成した後に、レーザー技術やめっき技術などを用いて一層ずつ積み重ねていく多層基板で...
株式会社グローセル
440人以上が見ています
返信の早い企業
100.0% 返答率
11.3時間 返答時間
■特徴 ・IVH、レーザービア、貫通THの組合せ加工が可能 ・各種ビルドアップ、エニーレイヤー基板による高密度基板が可能 ・高密度微細加...
株式会社大昌電子
60人以上が見ています
最新の閲覧: 15時間前
高密度化を徹底追求した全層レーザー/フィルドビア接続のビルドアップ多層配線板。コアレス積層による薄型化も対応致します。 レーザー...
株式会社ケイツー
80人以上が見ています
最新の閲覧: 1日前
100.0% 返答率
122.3時間 返答時間
■ビルドアップ基板とは コアとなる基板の上に、1段ずつレーザビアを形成しながら積層する工法です。1層ごとにレーザビアを形成するため...
京セラ株式会社
840人以上が見ています
最新の閲覧: 2時間前
返信の比較的早い企業
評判のとても良い企業
5.0 会社レビュー
100.0% 返答率
25.2時間 返答時間
■業界最先端のデザインルールに適応したビルドアップサブストレート 京セラのFC-BGA基板はファインなデザインルールを可能にした高信頼...
伊原電子工業株式会社
540人以上が見ています
最新の閲覧: 4時間前
100.0% 返答率
39.4時間 返答時間
体層を1層ずつ積み上げてレーザーVIAで層間接続を取るビルドアップ構造により、VIAによる配線スペースの占有を大幅に少なくできます。配...
京セラ株式会社
640人以上が見ています
最新の閲覧: 36分前
返信の比較的早い企業
評判のとても良い企業
5.0 会社レビュー
100.0% 返答率
25.2時間 返答時間
■技術開発力を駆使した最先端技術のご提案 スマートデバイス市場では、製品のさらなる小型化・薄型化・軽量化のニーズが高まっておりま...
OKIサーキットテクノロジー株式会社
1260人以上が見ています
最新の閲覧: 1時間前
100.0% 返答率
68.5時間 返答時間
FiTT (Fine pitch Through via Technology) 工法により0.35mmピッチ、1,000ピンBGA対応 32層プリント配線板を実現 特長 ・狭ピッチ、...
京セラ株式会社
490人以上が見ています
最新の閲覧: 2時間前
返信の比較的早い企業
評判のとても良い企業
5.0 会社レビュー
100.0% 返答率
25.2時間 返答時間
■搭載部品の狭ピッチ化に伴い多重多層構造を実現 高多層基板は、サーバーやルーター/スイッチ、基地局などの情報通信機器をはじめ、半導...
株式会社ウイル
540人以上が見ています
最新の閲覧: 1日前
■競争力のある価格、サーマルヘッド基板 常に耐EMIを意識したレイアウト、配線を環境にやさしい素材でご提供します。高品質、低価格、多...
伸光写真サービス株式会社
1050人以上が見ています
最新の閲覧: 16時間前
返信のとても早い企業
100.0% 返答率
5.6時間 返答時間
IVH基板、BVH基板とは配線密度を向上させた多層プリント基板になります。 ・IVH基板は多層基板において、穴を貫通させずに必要な層間の...
リンクステック株式会社
120人以上が見ています
最新の閲覧: 1日前
■特徴 ・15μmプリプレグを使用し「6層140μm」の極薄を実現 ・ピッチを100μmまで狭め、60GHzの信号をサポート可能な高密度特性を実現 ・...
株式会社スコットデザインシステム
360人以上が見ています
最新の閲覧: 1日前
シールドフレキシブル基板 (シールドFPC基板) とは、高周波信号の高速伝送/ノイズ対策のためのシールド構造を持たせたフレキシブル基板 ...
伊原電子工業株式会社
600人以上が見ています
最新の閲覧: 1日前
100.0% 返答率
39.4時間 返答時間
非貫通スルーホール (IVH・BVH) の採用により、基板の高密度化・小型化が可能となります。
シイエムケイ・プロダクツ株式会社
60人以上が見ています
最新の閲覧: 1日前
昨今の狭ピッチ・多ピンパッケージを実装する多層板の要望に対し、設計上で優位性があるビルドアップ仕様基板がますます注目されており...
株式会社京写
820人以上が見ています
最新の閲覧: 16時間前
返信のとても早い企業
100.0% 返答率
3.9時間 返答時間
表裏両面及び数層にわたり導体パターンを構成したプリント配線板です。両面基板については、スルーホールだけでなくノンスルーホール基...
株式会社丸和製作所
280人以上が見ています
■概要 導体が3層以上のプリント配線板です。通常のラミネート工法以外にビルドアップ工法も可能です。 ■製品例 高密度、高速...
3種類の品番
株式会社シグナス
200人以上が見ています
最新の閲覧: 22時間前
非貫通の導体間接続用Via。外層から内層の途中まで貫通させ、スルーホールを形成させるIVH、 内層のみを貫通させるBVHがあります。簡易...
2種類の品番
株式会社ウイル
510人以上が見ています
最新の閲覧: 1日前
■競争力のある価格、高い技術力、強い連携力、プリント配線基板 常に耐EMIを意識したレイアウト、配線を環境にやさしい素材でご提供しま...
株式会社大昌電子
70人以上が見ています
最新の閲覧: 1日前
ビルドアップ構造のサブストレートです。当社では、ビルドアップ層に主にプリプレグを用いることで、高い寸法精度と優れた微細配線を実...
リンクステック株式会社
90人以上が見ています
最新の閲覧: 4時間前
■特徴 ・キャビティへ部品を直接実装を可能にする高精度なザグリ加工により、コンパクト化に貢献 ・優れた銅めっき技術により、様々な形...
シイエムケイ・プロダクツ株式会社
50人以上が見ています
最新の閲覧: 1日前
多層プリント配線板のなかで、埋め込み穴、盲穴により接続された回路を形成しているものを、IVH基板といいます。高密度配線を行うため、...
株式会社ウイル
520人以上が見ています
最新の閲覧: 1日前
■競争力のある価格、ICタグカード COB基板 (無電解Auメッキ) 常に耐EMIを意識したレイアウト、配線を環境にやさしい素材でご提供します...
株式会社松和産業
150人以上が見ています
最新の閲覧: 23時間前
100.0% 返答率
360.2時間 返答時間
〇松和産業はアルミベース基板・厚銅基板・銅インレイ基板・導電性ペースト埋め基板まで幅広く対応 〇用途や仕様に合わせた最適な放熱ソ...
4種類の品番
株式会社ウイル
1120人以上が見ています
最新の閲覧: 5時間前
■6層 14層リジッドフレックス基板 メタルコア (アルミ) 基板 競争力のある価格、常に耐EMIを意識したレイアウト、配線を環境にやさしい...
株式会社ウイル
580人以上が見ています
最新の閲覧: 18時間前
■2段 スタックビルドアップ 8層基板 10層基板 6層貫通基板 競争力のある価格、常に耐EMIを意識したレイアウト、配線を環境にやさしい...
検索結果 54件 (1ページ/2ページ)
監修: OKIサーキットテクノロジー株式会社

ビルドアップ基板は、何層も積層されているプリント基板のことをいいます。
ビルドアップ基板を使用することで、小さい面積で、密度の高い基板が使用することができるので、小型の機器などでも多機能の製品を作成することができます。ビルドアップ基板は導体の層と絶縁体の層が何層も積み重なり、層を貫通するようにレーザーによる穴あけや配線加工がなされており、小さい面積の複雑な基板を入手することができます。
基板の高密度化に伴い、現行のビアホールの構造だけでの対応が難しくなってきました。携帯電話の発展により軽量・小型化に対応する基板が必要なってきました。ビルドアップ基板は2000年頃から登場し、現在に至ります。
ビルドアップ基板とは、欧米での分類では、マイクロビアという方法がされていましたが、海外ではHDI (英: HIGH density inter connection) Micro-via Laser-viaという名称で言われています。日本では、主にビルドアップという名称が主流です。ビルドアップ基板 (積み上げ) という意味の通り、何層も積層されているプリント基板のことをいいます。
通常、1回の積層 (積み上げ) で多層基板ができる所を何回も積み上げるため工数や費用が増えますが、主に下記2つの理由から活用が進んでいます。
多層基板に関して、バイアホール (穴を開けて他の層とつなぐもの) を使用した場合、接続層以外の所はビアがあるため、配線を行う事ができません。そのため、多層板にしても配線の効率があがらなくなります。
装置の進歩により、ドリルよりもレーザーの方が高速で小さい穴をあける事が可能となりました。ドリルで穴をあける場合は、下の層を突き破ってしまいますが、レーザーの場合は条件を組み合わせると樹脂には穴を開けて、銅の上で加工が止めることが可能です。
そのため、多層化した後にレーザーで穴を開け、メッキをして更に次の層をビルドアップしレーザーで加工をする工程を積み重ねる (ビルドアップする) ことで、ビアホールのエリアが有効に使われて高密度が可能となります。
ビルドアップ基板を使用することで、小さい面積で密度の高い基板が使用することができるため、小型の機器などでも多機能の製品を作成することが可能です。小さい面積の複雑な基板を入手することができます。
ビルドアップ基板は、小型で軽量の電子機器に幅広く使用されています。ビルドアップ基板が実用化された当初は、パソコンや携帯電話で使用されていましたが、現在は小型の計測機器や、スマートメーターなどのIoT機器、デジタルカメラのモジュール、PCの周辺機器などで使用されています。
ビルドアップ基板の製造工程における穴あけ加工などの精度は規格が定まっており、ビルドアップ基板の作成を依頼する際にはどの程度の精度で依頼するかを正確に選択する必要があります。
ビルドアップ基板の製造工程としては、絶縁体層の形成、ビア加工、スミアの除去、ビアへのめっきなどがあります。
プリント基板の上に絶縁体層をビルドアップします。方法は、リジッドの材料であるプリプレグを使用する場合はフィルムを使う場合があります。プリプレグは、デジカメやスマホの半導体のパッケージに使われる場合が多いです。
基板と基板の間の絶縁体層にビアと呼ばれる穴をあける工程です。現在はレーザーを使用して穴を開けることが一般的です。
レーザーも炭酸ガスやUV-YAG等の種類と波長を使います。炭酸ガスは波長が長い赤外線のため、デジカメやスマホに良く使われます。UV-YAGは波長が短い紫外線のため、半導体のパッケージ基板のような高密度な領域に使われます。
レーザー加工によって発生した残渣をスミアと呼びます。樹脂が残っていると接続ができないため、除去する必要があります。この工程をデスミアと呼びます。スミアがビルドアップ基板に残っていると接続不良などに繋がるため、確実に除去する必要があります。
強力な薬品 (過マンガン酸カリウム) で除去する必要がありますが、最近の高速に対応した樹脂は除去できない場合があるため、プラズマ等を併用する場合があります。
絶縁体を挟んだ基板同士で、回路をつなぐためにビアにめっきをします。小さい穴にメッキするため、気泡が入らないようにする必要があります。
穴の配置・構造によって名称が変わりますので、簡単に解説をします。
スタガードビア
階段の様にビアの位置をずらす方法です。
スタックビア
ビアの上にまたビアを重ねていきます。すべての層でビアが重なっているものはフルスタックビアと呼ばれています。
IVH (英: Interstitial VIA Hole) 内部にあるビアホール
ビルド以外の層は、上下に接続する穴をドリルを使って設ける必要があります。構造的に基板の中にある穴であることからこのような表記が使われます。ブラインドビアという言い方もされます。ビルドアップ層とIVHの層を分けて記載するのが通例です。
例) 3-6-3 ビルド 表 3層 IVH 6層 ビルド 裏 3層 合計12層
ビルドアップ基板はコア層の両方の面に配線する層を積み重ねますが、全ての層がビルドアップ層の場合エはニーレイヤー基板といいます。
先ほどの表記でいうと、3-0-3 (6層エニーレイヤー) ということになりますが、使ってない層を0というのは座りが悪いため、層数+エニーレイヤーという言い方になっています。
エニーレイヤー基板はスルーホールを形成するコア層を必要としません。ビルドアップ基板は、IVHの所は従来の基板の導通となりますが、エニーレイヤー基板はレーザーで開けられた小径のビアホールのみで自由に各層の間を繋げられます。
これらの特徴の違いから、エニーレイヤー基板は通常のビルドアップ基板よりも高密度が可能となり、製品の軽薄短小化に繋がります。工程数や費用が多くなりますが、上記理由でスマホ等に多く使用されています。図を参照してください。
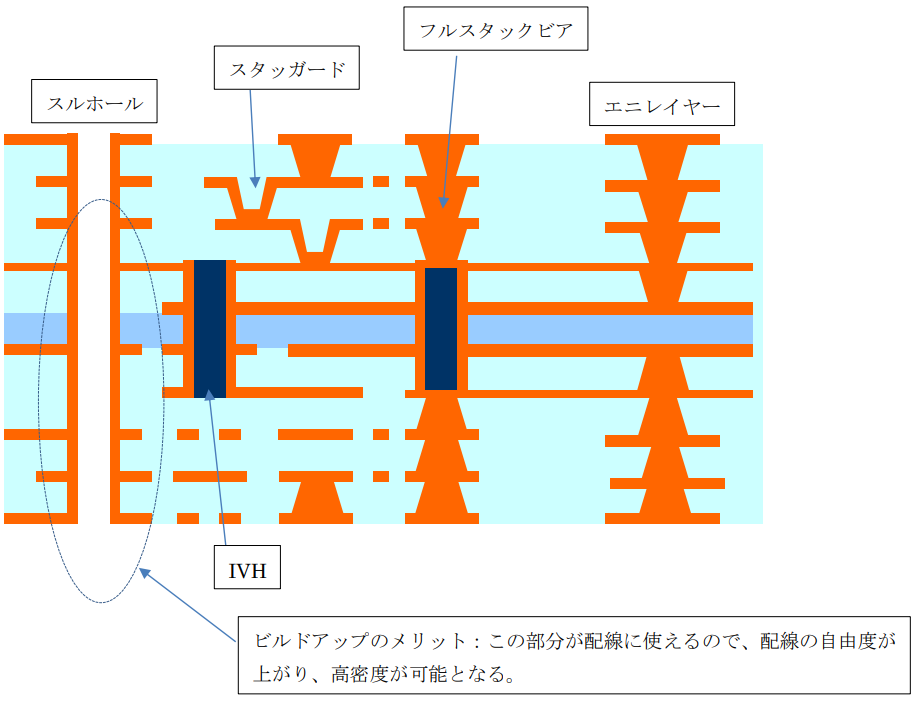
図1. ビルドアップ基板の各構造の名称
現在は、通常の基板材料と同じガラスクロス材や主にパッケージに使われているフィルムの2種類が主流です。過去を見ると、色々な材料が使われてきました。
元々ビルドアップ基板は、IBMが自社の製品群に対して、大型コンピューターフリップチップ実装に対応できる技術を開発して来たことがスタートです。その中で各種検討を行ってきました。
その結果、フォトビアと言われている紫外線硬化樹脂を用いて、露光・現像を行う方式を採用しました。これは、一括でビアが形成できるというメリットがありました。層間厚が必要のため、膜厚が稼げる、カーテンコーター用のソルダーレジストの材料をベースに開発を行い、量産化しました。ソルダーレジストと同じように、塗布して露光現像をして、その後、熱で最終硬化を行い絶縁層を形成しました。
その後、化学銅を析出して、電気銅メッキを行い、層を重ねてゆくプロセスです。IBMが立ち上げた事により、弊社含めて各メーカーは開発を行いましたが、光によるビア形成は、形状を安定させる事が非常に難しく、また、化学銅の形成はもともと、光重合を起こす樹脂のため、ピール強度がでにくく、条件管理が非常に難しいという難点がありました。また、現像が溶剤であり、各種規制があり、普及される技術とは言えませんでした。
その後、マイクロビアの形成方法であるが、レーザー加工装置の大幅な進化により、ビアの加工速度が何十倍にも上がった事により、光による形成から、レーザー加工による形成に変わりました。その時、RCC (レジンコーテドコッパーフォイル:樹脂付き銅箔) が採用されてきました。これは、熱硬化の樹脂であり、銅箔の上に樹脂をコーテングして、プリプレグと同じ半硬化の状態にした物です。
そのため、従来の基板と同じプロセスである、積層のプロセスが使えるメリットがありました。また、ピール強度もでやすいため、ビアは光による形成から、RCCのレーザーによる形成へ置き換えが進みました。
電子機器の小型化及びハンデイー化が進み、ビルドアップ基板の用途は拡大してきました。その中で更なる、コストダウン及び高密度に対応できる信頼性が求められました。
また、レーザーの出力アップ加工技術の大幅な改善により、一般的に使われているガラスクロス入りの材料での加工が可能となったため、ガラスクロス入りの材料への意向が大幅に進みました。携帯電話やデジカメなどの各種モバイルは、このタイプです。
一方、LSIのパッケージにおいて、LSIの高密度化 フリップチップの対応で、高密度の多段のビルドアップが求められてきました。多段化及び薄型の対応のため、層間の厚さが薄く、また、より小さいビア及び表面のフラット性が要求されました。それに対応するためにフィルムタイプの材料が開発されました。
回路の中に樹脂を充填するため、真空ラミネーターが必須であり、また、樹脂表面に化学銅を析出させるのに、独自のプロセス専用のラインが必要となります。そのため、大型な設備投資が必要となります。パッケージ用途では、PCスマホのMPU大規模なLSIに使われています。
本記事はビルドアップ基板を製造・販売するOKIサーキットテクノロジー株式会社様に監修を頂きました。
OKIサーキットテクノロジー株式会社の会社概要はこちら