制御・計測・センシング
駆動・機械要素・電子制御部品
産業別カテゴリ
電源・エネルギー・熱処理機器
安全・保護・環境対策
材料・素材・ケミカル
電気・電子部品
構造部品・締結要素
ソフトウェア・ネットワーク
サービス
その他
全てのカテゴリ
閲覧履歴
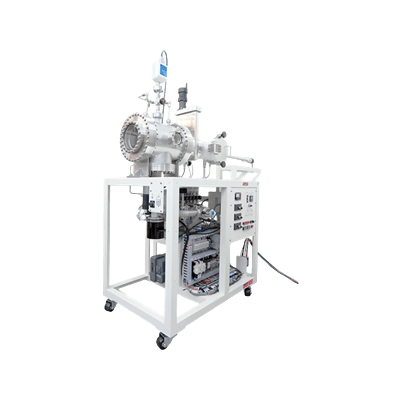
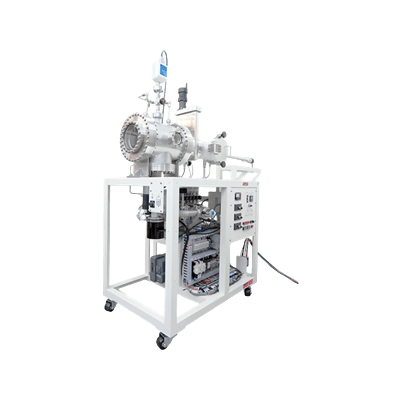
装置構成 搬送系 (標準)
手動トランスファーロッド
装置構成 モジュール
試料交換室×1室 プロセス室×1室
真空槽 プロセス室
熱CVD室 コールドウォール式
到達圧力 試料交換室 (標準)
≦1.0×10^ー1Pa (プロセス室 真空ポンプ共用)
到達圧力 プロセス室 (標準)
≦1.0×10^ー1Pa
真空槽
SUSチャンバ
排気系 主排気ポンプ
試料交換室、プロセス室共用:油回転真空ポンプ
排気系 補助ポンプ
試料交換室、プロセス室共用:メカニカルブースタポンプ
排気系 各種バルブ
手動式
真空計 低真空
ピラニ真空計
真空計 高真空 圧力制御
ワイドレンジ真空計
基板サイズ
MAX3インチ (付属専用ホルダ) 不定形状可能
反応性ガス
H2+WF6 (プロセス室構成例)
槽内アクセス アクセスドア
試料交換室:Oリングシール プロセス室:CFフランジ
制御系 主操作
手動 制御盤 各種操作パネル
機能 (例) 試料交換室
トランスファーロッド (ホルダ×1式積載)
機能 (例) CVD室
成膜ステージ (X) 基板加熱 (常用700℃、MAX800℃)
オプション 圧力制御
絶対圧真空計
オプション 水冷機構
冷却水循環装置
オプション 排気バルブ
自動バルブ
ユーティリティ 電力
3Φ AC200V 50/60Hz 50A (プロセス室構成例)
ユーティリティ 冷却水
供給圧:0.2~0.3MPa 水温:20~28℃ 水量:≧5L/min (プロセス室構成例)
ユーティリティ プロセスガス
Ar、H2 (プロセス室構成例)
ユーティリティ ペントガス
窒素ガス 0.1~0.15MPa
ユーティリティ 圧縮空気
0.5~0.8MPa
ユーティリティ 設置面積
(W×D×H) =1.7m×0.8m×1.8m (プロセス室構成例)
型番
金属熱CVD装置シリーズ
CVD装置 金属熱CVD装置取扱企業
株式会社日本シード研究所カテゴリ
もっと見る
半導体製造装置の製品203点中、注目ランキング上位6点
電話番号不要
何社からも電話が来る心配はありません
一括見積もり
複数社に同じ内容の記入は不要です
返答率96%
96%以上の方が返答を受け取っています
返答時間が24時間以内の企業の中での注目ランキング
電話番号不要
何社からも電話が来る心配はありません
一括見積もり
複数社に同じ内容の記入は不要です
返答率96%
96%以上の方が返答を受け取っています
| 商品画像 | 価格 (税抜) | 装置構成 搬送系 (標準) | 装置構成 モジュール | 真空槽 プロセス室 | 到達圧力 試料交換室 (標準) | 到達圧力 プロセス室 (標準) | 真空槽 | 排気系 主排気ポンプ | 排気系 補助ポンプ | 排気系 各種バルブ | 真空計 低真空 | 真空計 高真空 圧力制御 | 基板サイズ | 反応性ガス | 槽内アクセス アクセスドア | 制御系 主操作 | 機能 (例) 試料交換室 | 機能 (例) CVD室 | オプション 圧力制御 | オプション 水冷機構 | オプション 排気バルブ | ユーティリティ 電力 | ユーティリティ 冷却水 | ユーティリティ プロセスガス | ユーティリティ ペントガス | ユーティリティ 圧縮空気 | ユーティリティ 設置面積 |
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
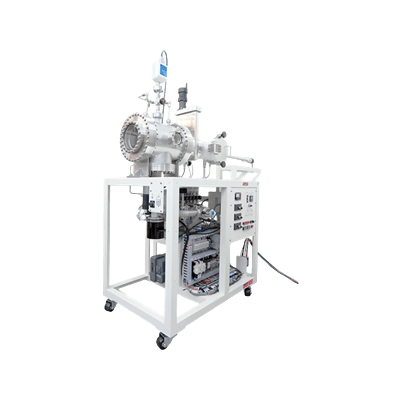
|
要見積もり | 手動トランスファーロッド |
試料交換室×1室 プロセス室×1室 |
熱CVD室 コールドウォール式 |
≦1.0×10^ー1Pa (プロセス室 真空ポンプ共用) |
≦1.0×10^ー1Pa | SUSチャンバ | 試料交換室、プロセス室共用:油回転真空ポンプ | 試料交換室、プロセス室共用:メカニカルブースタポンプ | 手動式 | ピラニ真空計 | ワイドレンジ真空計 |
MAX3インチ (付属専用ホルダ) 不定形状可能 |
H2+WF6 (プロセス室構成例) |
試料交換室:Oリングシール プロセス室:CFフランジ |
手動 制御盤 各種操作パネル |
トランスファーロッド (ホルダ×1式積載) |
成膜ステージ (X) 基板加熱 (常用700℃、MAX800℃) |
絶対圧真空計 | 冷却水循環装置 | 自動バルブ | 3Φ AC200V 50/60Hz 50A (プロセス室構成例) |
供給圧:0.2~0.3MPa 水温:20~28℃ 水量:≧5L/min (プロセス室構成例) |
Ar、H2 (プロセス室構成例) |
窒素ガス 0.1~0.15MPa |
0.5~0.8MPa |
(W×D×H) =1.7m×0.8m×1.8m (プロセス室構成例) |
半導体製造装置の中でこの商品と同じ値をもつ製品
工程分類が成膜装置の製品
半導体製造装置をフィルターから探すことができます
使用用途
#成膜 #エッチング #洗浄 #アッシング #イオン注入 #検査 #搬送 #アライメント #パターニング #組立 #封止 #計測工程分類
成膜装置 リソグラフィ装置 エッチング装置搬送方式
バッチ式 シングル式 クラスター式 真空搬送式成膜方式
化学気相成長型 物理気相成長型 スピンコート型ウェハーサイズ mm
0 - 100 100 - 150 150 - 200 200 - 250 250 - 300 300 - 350チップサイズ mm
0 - 1 1 - 2 2 - 5 5 - 10 10 - 20 20 - 35基板サイズ mm
0 - 50 50 - 100 100 - 200 200 - 300 300 - 500処理能力 秒/chip
0 - 1 2 - 31ボンディング精度 μm
0 - 1 1 - 3 3 - 6 6 - 13 13 - 21電源電圧 V
90 - 120 120 - 220 220 - 260