プラズマCVD装置とは
プラズマCVD装置とは、化学気相成長法の一種を行う装置です。
プラズマCVDはPlasma-Enhanced Chemical Vapor Depositionの略で、原料ガスを低温プラズマ状態 (陽イオンと電子に電離したグロー放電) にし、活性なイオンやラジカルを生成して基盤上で化学反応を起こし、堆積させて薄膜を形成します。
プラズマCVD装置の使用用途
プラズマCVD技術は、切削工具の強化膜 (窒化チタン、窒化炭素、DLC (英: Diamond Like Carbon) ) 、半導体の絶縁膜・保護膜・配線・電極材料 (窒化シリコン、酸化シリコン、銅、アルミニウム、タングステン、多結晶シリコン、化合物半導体など) などに使われています。経済・産業発展の鍵を握るエネルギーの制御や供給を行うための高性能パワーデバイスへの活用も急速に広がっています。
プラズマCVD装置への供給ガスには通常、水素、窒素、アルゴン、アンモニアなどのキャリアガスに、SiH4 (シラン) 、WF6 (六フッ化タングステン) などの原料ガスを混入させたものを用いる場合が多いです。
1. 酸化物
二酸化ケイ素 (SiO2) はシリコンの酸化物です。電気絶縁性と熱安定性に優れており、半導体デバイス層間絶縁膜で使われています。
半導体の薄膜化により、電流が予定していない箇所から漏れ出してしまうリーク電流が発生しやすくなります。SiO2があることで、リーク電流の防止につながります。
2. 窒化物
窒化ケイ素 (Si3N4) はシリコンの窒化物です。強度や熱伝導率に優れており、熱量が多く発生するパワーデバイス向けの基板材料に用いられています。
窒素、アンモニアはSiH4とともに窒化物を形成する際に用いられているため、原料ガスの役割も持っています。一般的な半導体はメモリなど、演算や記憶に関する働きをします。一方パワーデバイスはダイオードのように、ためのものです。
3. 炭化物
炭化ケイ素 (SiC) はGaN (窒化ガリウム、ガン) 、AlGaNなどとともに化合物半導体の仲間でシリコンの炭化物です。Si3N4同様、強度や熱伝導率に優れていることから、SiのIGBTに代わってパワーデバイス向けで使われています。
シリコン化合物に比べて電力損失が少なく、装置の小型化につながります。
4. 金属・金属化合物
トランジスタのゲートはゲート酸化膜 (熱酸化で形成します) とゲート電極 (多くは多結晶シリコン) から形成されます。ゲート電極、ソース・ドレインのコンタクトに使われるタングステンプラグはプラズマCVDで形成されます。 (図3参照)
プラズマCVD装置の原理
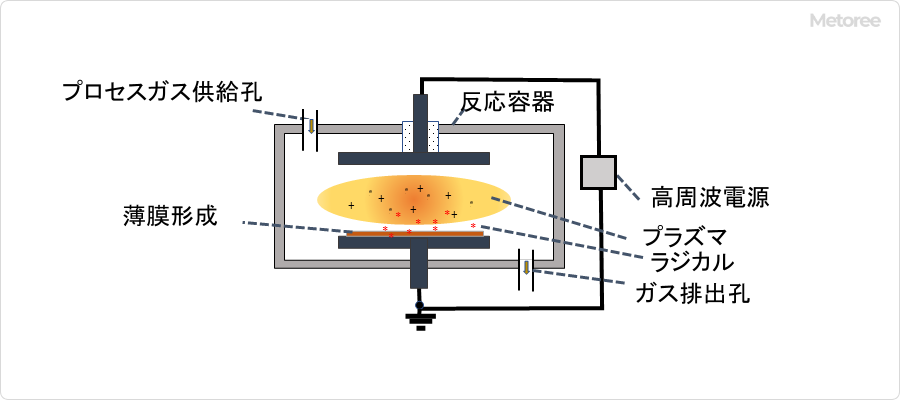
図1. プラズマCVD装置の基本構成
原料ガスは目的に応じて10-4~100Pa程度の幅のある減圧範囲から目的に応じた条件を選びます。最も一般的にプラズマ励起に用いられている電源周波数は13.56 MHz (RF:Radio Frequency) であり、放電形式は図1に示すように平行平板電極を用いた容量結合型になります。
並行平板の一方をプロセスガスを供給するシャワーヘッドに用いたり、一方にヒータを入れて温度調節したりする場合もあります。電源周波数、並行平板型以外の電極構造、原料ガスの組成、吐出量、温度など、コントロール可能なパラメータは多いです。そのため、無機物質から有機物質まで、様々な機能性を持たせた各種の薄膜の成膜が可能です。
プラズマCVD装置のその他情報
1. 半導体デバイスの構造と製法

図2. 半導体デバイス (メモリ) の基本構造
プラズマCDV装置は半導体デバイスの製造に多用されますが、例えばメモリデバイスの場合は、図2に示すように基板 (ウエハー) 上に形成されたMOSFET (Metal Oxide Semiconductor Field Effect Transistor) の上に多層の複雑な配線層が形成され、層間絶縁膜で分離されています。
MOSFETのゲート電極、配線層、層間絶縁膜などの形成にプラズマCVD装置が主として用いられますが、成膜後に細かいパターン形成が必要です。パターン形成には、基本的には印刷技術が用いられ、図3に示すように以下の手順の繰り返しになります。
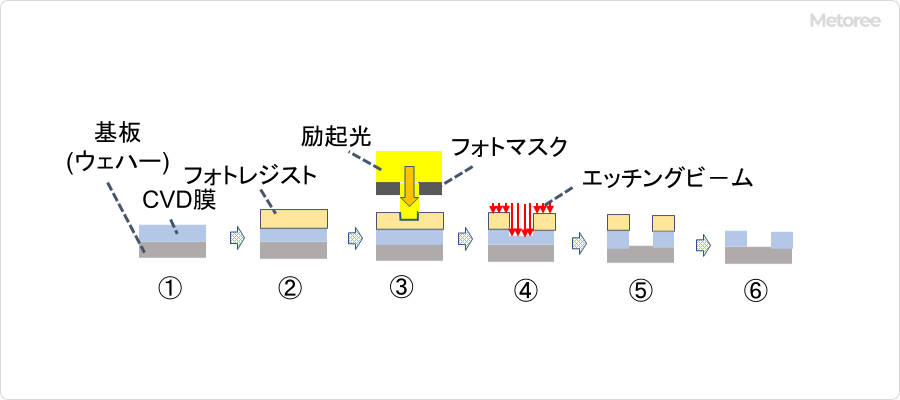
図3. 半導体デバイスの基本成膜プロセス
-
- 下地のパターンの上に、新たに形成するパターンの材料 (多結晶シリコン、Al、 C、W、 SiO2、Si3N4など) を均一にCVDで成膜します。
- 1の成膜の上に、 (ポジまたはネガ) フォトレジスト膜を形成します。ポジ膜は励起光のよって、溶剤に溶けにくくなり、ネガ膜は溶けやすくなります。
- レジストを溶かし、成膜の上に溶け残ったレジストのパターンを形成します。
- パターン上部からエッチング (剥離工程) をかけ、成膜を除去します。
- レジストを除去します。
- 成膜にパターンが形成されます。
以上のプロセスを繰り返すことによって、図2に示したような半導体デバイスが形成可能です。
2. 熱CDVと光CDV
与えるエネルギーによって、プラズマCVD、熱CVD、光CVDに分類できます。
- 熱CVD
供給ガスを高温で処理することにより、成分を熱分解・化学反応させ、成膜する方法です。基板がプラスチックなど、熱に弱いものには使えません - 光CVD
レーザー光や、紫外線のエネルギーを用いて科分解・化学反応を活性化する方法